電子回折による結晶性評価
透過電子顕微鏡(TEM)では電子回折パターンを取得でき、試料の結晶性や結晶構造の評価が可能です。
事例1. 結晶性の異なるSiの評価
下の写真はXe照射によってSiO2上非結晶質Siをエピタキシャル成長させた試料です。
Si基板上に直接成長させた部分(写真a)では、完全な単結晶を示しています。SiO2層端部の成長層(写真b)では{111}方位に3倍周期の過剰斑点が観察され、高密度の積層欠陥の発生を示しています。また、SiO2層端部より500nm以上離れた領域(写真c)では、完全なアモルファスを示しています。
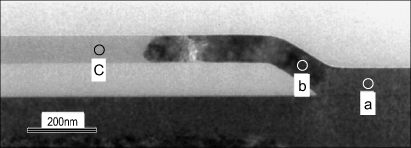



事例2. NBDによる格子面間隔変化の測定
STEM暗視野像を見ながら、任意の箇所でのナノビーム電子回折(Nano beam electron diffraction : NBD)の取得が可能です。得られたNBD図形から、格子面間隔の変化率の算出が可能であり、カラー描画により変化率を可視化できます。
測定例
段階的に組成が変化したⅢ-Ⅴ族化合物試料について実施し、AlN部分の面間隔を基準とした、垂直方向(成長方向)および水平方向の面間隔の変化率を描画しました。
※ NBD測定箇所測定エリア 縦2.7μm X 横2μm
測定ピッチ 縦15点 X 横5点
プローブ径 0.5nm
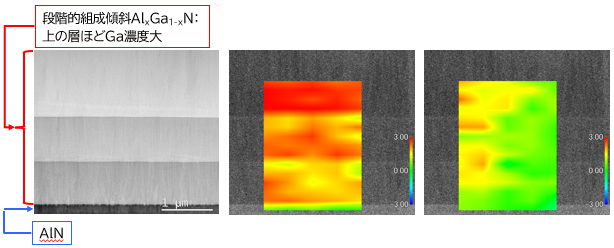
中央:垂直方向の面間隔変化率[%]
右:水平方向の面間隔変化率[%]
応用例
- プロセス後のデバイス内部の歪み解析
- 組成傾斜試料の格子面間隔の変化の解析