Nitrid-Halbleiter-Epitaxialwafer

Was ist ein Nitrid-Halbleiter-Epitaxie-Wafer?
Von Leistungsgeräten, die Nitridhalbleiter verwenden, wird erwartet, dass sie umweltfreundliche Geräte sind, die die zukünftige kohlenstoffarme Gesellschaft unterstützen.
NTT-AT trägt mit seiner Nitrid-Halbleiter-Epitaxie-Wafer-Fertigungstechnologie zur frühen Verwirklichung der Energieeinsparung bei.
Bei Nitrid-Halbleitern, wie beispielsweise Galliumnitrid (GaN), wird erwartet, dass sie die nächste Generation von Leistungshalbleitern darstellen, da sie zu hoher Leistung, hoher Spannungsfestigkeit, hoher Frequenz und geringem Verlustbetrieb fähig sind und damit die Grenzen der derzeit weit verbreiteten Si-Leistungshalbleiter übertreffen.
Stehen Sie bei der Entwicklung von Leistungselektronikgeräten vor einer oder mehreren der folgenden Herausforderungen?
- Ich möchte verschiedene Arten von Substraten ausprobieren, für die noch keine Entscheidung getroffen wurde, welche Art von Substrat verwendet werden soll.
- Wir möchten ein zukünftiges Massenproduktionssystem sichern, während wir eine Probeproduktion mit einer kleinen Menge verschiedener Produkte durchführen.
- Natürlich ist auch ein großer Durchmesser erforderlich.
Nitrid-Halbleiter-Epitaxie-Wafer von NTT-AT
- Wir verfügen über die Technologie, um Kristalle auf Substraten aus Silizium (Si), Saphir (Al2O3), Siliziumkarbid (SiC) und Galliumnitrid (GaN) zu züchten, und können alle Substrate verarbeiten, die für Nitridsysteme verwendet werden. Entwicklungsstudien mit mehreren Substrattypen können parallel durchgeführt werden. Wir verschwenden Ihre wertvolle Zeit nicht.
- Wir akzeptieren Aufträge von kleinen Prototypen bis hin zur Massenproduktion.
- Wir unterstützen auch 8-Zoll-Siliziumsubstrate mit großem Durchmesser. Darüber hinaus sind Gerätefertigung und Materialanalyse durch die Zusammenarbeit mit unseren verwandten Abteilungen möglich.
Anwendungsbeispiel

- USB kleines Schnellladegerät
- LED-Straßenleuchte
- Stromversorgungsgeräte für mobile Basisstationen
- Kfz-Leistungsgerät
- Leistungsgeräte für Haushaltsgeräte
- Umweltbeständiges Gerät
HEMT structure for Power application (on 6 inch Si)
Wir haben Produkte, die sofort lieferbar sind. Bitte Anfragen auf Englisch.
Durch Anklicken der gewünschten Teilenummer wird Anfragen auf Englisch angezeigt.
Wir entschuldigen uns für die Unannehmlichkeiten, aber bitte geben Sie die [Teilenummer] und die [Menge] im Anfragefeld an.
| Artikelnummer | GaN-Kappe | AlGaN-Barriere | AlN | Kanal | |
|---|---|---|---|---|---|
| Inhalt | Dicke | Abstandshalter | |||
| SEE61K22227S20G | 2nm | 0.22 | 27 nm | 1nm | 200nm |
| SEE61K22227S30G | 2nm | 0.22 | 27 nm | 1nm | 300 Nanometer |
| SEE61K22515S30G | 2nm | 0.25 | 15 nm | 1nm | 300 Nanometer |
| SEE61K22520S30G | 2nm | 0.25 | 20nm | 1nm | 300 Nanometer |
| SEE61K22525S30G | 2nm | 0.25 | 25nm | 1nm | 300 Nanometer |
| SEE61K23020S30G | 2nm | 0.30 | 20nm | 1nm | 300 Nanometer |
| SEE61K21745N30G | 2nm | 0.17 | 45nm | - | 300 Nanometer |
| SEE61K22520N30G | 2nm | 0.25 | 20nm | - | 300 Nanometer |
| SEE61K22520N35G | 2nm | 0.25 | 20nm | - | 350nm |
| SEE61K22520N40G | 2nm | 0.25 | 20nm | - | 400 Nanometer |
| SEE61K22526N15G | 2nm | 0.25 | 26nm | - | 150nm |
| SEE61K22526N20G | 2nm | 0.25 | 26nm | - | 200nm |
| SEE61K22526N35G | 2nm | 0.25 | 26nm | - | 350nm |
| SEE61K22527N35G | 2nm | 0.25 | 27 nm | - | 350nm |
| SEE61K23020N30G | 2nm | 0.30 | 20nm | - | 300 Nanometer |
| SEE61K02822S30G | - | 0.28 | 22nm | 1nm | 300 Nanometer |
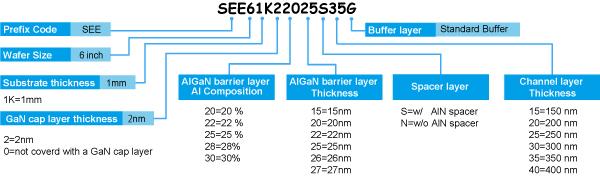

| Deckschicht | |
|---|---|
| Materialien | GaN |
| Dicke | 2 (nm) oder keine Obergrenze |
| Barriere | |
| Materialien | AlGaN |
| Al Inhalt | 20~30 (%) |
| Dicke | 15~27 (sm) |
| Kanal | |
| Materialien | GaN |
| Dicke | 150~400 (nm) |
| Puffer | |
| Doping | C-Doping |
| Dicke | ~3900 (sm) |
| Substrat | |
| Silizium | 1 mm dick |
| Merkmale | |
| Flächenwiderstand: 350~400 Ohm/Quadrat (mit AlN-Abstandshalter), 450~500 Ohm/Quadrat (ohne AlN-Abstandshalter) Elektronenmobilität: ~1700 bis 1900 cm2 /Vs FWHM (002): <800 Bogensekunden FWHM (102): <1400 Bogensekunden Durchschlagspannung: 800V – 1000V (je nach Geräteaufbau) Bogenwert: < 50um |
|
Epitaxiales Produkt mit AlGaN/GaN-HEMT-Struktur (Beispiel)
| Pufferschicht | Material: (Al)GaN | |||
|---|---|---|---|---|
| Dicke: 1-3 μm | ||||
| Sperrschicht | Material: AlGaN mit oder ohne AlN-Spacer | |||
| dotiert oder undotiert | ||||
| Al-Gehalt: 10-50% | ||||
| Dicke: <~50nm | ||||
| Deckschicht | Material: GaN | |||
| dotiert oder undotiert | ||||
| Dicke: 0-5nm | ||||
| Substrat | Si | Saphir | SiC | GaN |
| 4 bis 8 Zoll * | 2 bis 3 Zoll | 2~6 inch | 2 bis 4 Zoll | |
*Bitte kontaktieren Sie uns, wenn Sie einen kleinen Durchmesser von 3 Zoll oder weniger benötigen.
Verfügbare Modellreihen (6 Zoll & 8 Zoll)
| on Si substrate | AlGaN/GaN HEMT structure | |
|---|---|---|
| 6 inch | 8 inch | |
| GaN-Kappe | ✔ | ✔ |
| in-situ SiN (~5nm) | ✔ | ✔ |
| in-situ SiN (~40nm) | ✔ | ✔ |
|
p-GaN (~80nm)
(Mg: 2x1019 cm-3) |
✔ | ✔ |
Materialien herunterladen
Datendokument: „Erwartete Verbesserung der Geräteausbeute – 8-Zoll-AlGaN/GaN-Epitaxie-Wafer mit ausgezeichneter Gleichmäßigkeit“
Bei Interesse bewerben Sie sich bitte über Anfragen auf Englisch.
Anfragen auf Englisch
Für Materialanfragen oder sonstige Anfragen auf Englisch, die nicht oben aufgeführt sind, nutzen Sie bitte Anfragen auf Englisch.
Verwandte Dienstleistungen
Für Kunden, die eine Struktur- und Bauteilanalyse an diesem Produkt oder Prototypgerät durchführen möchten,
- Morphologische Beobachtung für Geräte- und Materialmorphologie, Struktur und Kristallstrukturanalyse
- Chemische Analytik von der Spurenanalytik anorganischer und organischer Felder bis zur Hauptkomponentenanalyse
Für Kunden, die ihren Geräte-Prototyping-Prozess auslagern möchten
*Dieses Produkt fällt unter die beigefügte Tabelle 1, 7(18) der Exportkontrollverordnung des Ministeriums für Wirtschaft, Handel und Industrie, und für den Export ist eine Genehmigung des Ministeriums für Wirtschaft, Handel und Industrie erforderlich.
*Der Inhalt dieser Website kann aufgrund von Produktverbesserungen ohne vorherige Ankündigung geändert werden.
Dieses Projekt ist Teil der GX-Lösungsmarke „NTT G×Inno“, die von der NTT Group entwickelt wird.
*„NTT G×Inno“ ist eine eingetragene Marke der NTT Corporation.
Es ist eine Abkürzung für „NTT GX (Green Transformation) x Innovation“ und zielt darauf ab, der Gesellschaft Lösungen zu bieten durch
Dabei handelt es sich um eine Initiative, die Innovationen im GX-Bereich vorantreiben und dazu beitragen soll, bis 2050 CO2-Neutralität zu erreichen.
