ウエハ汚染評価事例1
-汚染回収方法と評価事例-
ウエハ表面に存在する汚染はデバイス特性を劣化させ、デバイスの製造歩留まりに大きな影響を与えます。ここでは誘導結合プラズマ質量分析(ICP-MS)によるシリコンウエハ表面上の金属汚染評価事例についてご紹介します。
評価対象としては、ウエハ表面全面、あるいは裏面全面に加え、任意の表面箇所(部分回収)やエッジ・ベベル部、ノッチ部を選択することができます。
| 面回収 | 部分回収 | エッジ・ベベル部回収 |
|---|---|---|
 |
|
 |
| A:円周状 | エッジ・ベベル部 | |
|
|
 |
|
| B:扇形 | ノッチ(V字刻み部) |
![]() 回収液:フッ化水素酸 等
回収液:フッ化水素酸 等
全面回収評価事例
全面回収ではウエハ表面全体の平均汚染量の情報が得られます。
| Na | Al | K | Ca | Fe | Cu | Zn |
|---|---|---|---|---|---|---|
| 0.67 | 6.0 | 0.29 | 0.16 | 0.25 | 0.27 | 0.30 |
【単位:×1010atoms/cm2】
*装置搬送後のウエハを測定
汚染の分布情報を得るには、次にご紹介します、部分回収が有効です。
部分回収評価事例
全面回収を実施した場合の汚染評価結果では、ウエハ表面全体の平均汚染量の情報しか得られず、汚染の分布情報を得ることができませんが、円周状回収のような部分回収を行うことで、汚染の分布情報を容易に得ることが可能になります。
A:円周状回収
300mmφウエハの中心(0mm~)から外周(~150mm)まで5箇所の領域に区分して、金属汚染を回収し、汚染分布の評価を行った事例を以下に紹介します。
※ 回収領域は、任意に設定できますので、お気軽にご相談下さい。
 |
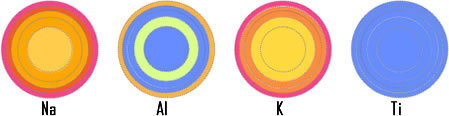
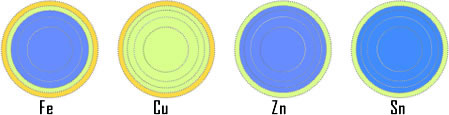
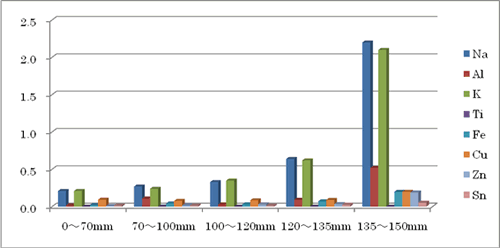
ウエハ中心部に比べて、ウエハケースや冶具に接触することが多い外周部に金属汚染が多いことが分かりました。
B:扇形回収
硬貨を接触・強制汚染させたウエハを90°ずつ、4箇所の領域に区分して、金属汚染を回収し、汚染分布の評価を行った事例を以下に紹介します。
※ 回収領域は、任意に設定できますので、お気軽にご相談下さい。
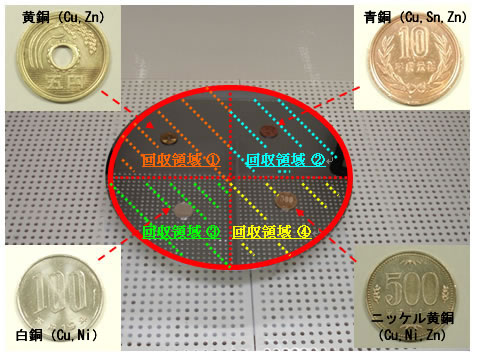

硬貨の材質がウエハに転写されていることが確認されます。 とりわけ、CuとNiについては、転写が顕著であることが分かります。
硬貨を接触・強制汚染させたウエハを全反射蛍光X線分析 全面高速マッピング(Sweeping-TXRF)を行いました。
1)Cu
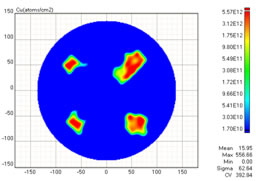
Cuの転写箇所が明確に確認できます。
(2)Sn

Snにおいては、転写量が少なかったため汚染分布が確認できませんでしたが、高感度なICP-MS分析では僅かながら汚染を検出できています。
エッジ・ベベル部回収の評価事例
エッジ・ベベル部回収の評価を行うことで、ウエハケースからの汚染評価を行うことができます。その事例を以下に紹介します。
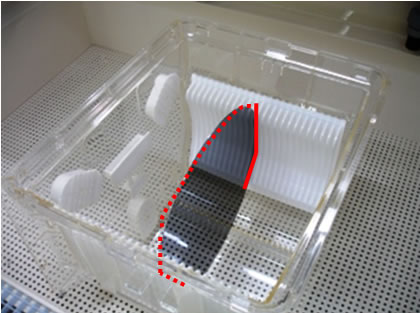

未洗浄ケースに保管したウエハからは金属汚染が検出されましたが、洗浄済みケースに保管したウエハからは、金属汚染が検出されませんでした。