ウエハ汚染評価事例
NTT-AT社では長年に渡り、全反射蛍光X線分析TXRFの手法を用い、さまざまな汚染評価を実施してきました。ここでは、分析事例の一部をご紹介します。
事例1. ウエハハンドリングツールからの転写汚染評価
ウエハ用のハンドリングツールは、ウエハとの接触部が清浄であることが重要です。
ツールの接触部が汚染されているとウエハに汚染が転写されてしまい、半導体製造の歩留まりや製品性能の低下を引き起こす一因となってしまいます。
ここでは、購入した真空ピンセットの先端チップから転写される汚染について評価した事例を紹介します。
汚染評価方法
購入した真空ピンセットについて、先端チップの清浄度を評価するため、購入直後の状態とIPAによる化学洗浄(※)を施した状態でウエハ表面に接触させ、Sweeping-TXRFを用いて汚染分布と汚染量を評価しました。
※洗浄はメーカー推奨の方法で行っています。
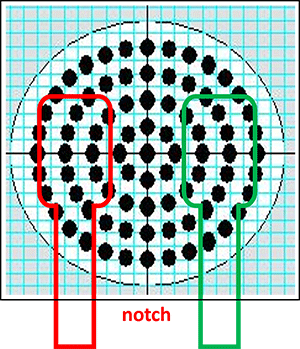
図1-1.汚染位置概略図
※ 図中の黒い部分は測定点を示します
| ウエハ | 8インチSiウエハ |
|---|---|
| 測定方法 | Sweeping-TXRF |
| 評価方法 | 真空ピンセットの先端チップをウエハ表面に接触させた後、Sweeping-TXRFで汚染状況を評価 |
| 接触方法 | ①ウエハの左側に購入してそのままの先端チップ(赤枠)を吸引状態で10秒間接触 ②ウエハの右側に洗浄後の先端チップ(緑枠)を吸引状態で10秒間接触 |
分析結果
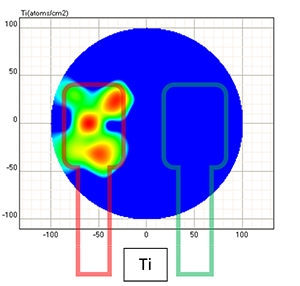
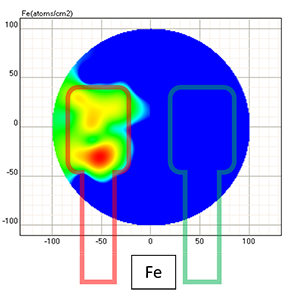
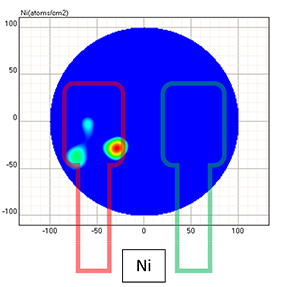
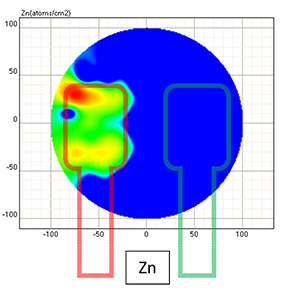
図1-2.汚染ウエハのSweeping-TXRF測定結果
測定の結果、洗浄の実施により先端チップからの汚染転写量が大幅に減少していることが確認できました。
このように、Sweeping-TXRFで分析することによって、ウエハハンドリングツールからの汚染状況を可視化し、清浄度を確認することができます。
事例2. 化合物半導体ウエハの表面汚染評価
高性能電子デバイスの製造には、GaN(窒化ガリウム)、InP(リン化インジウム)などの化合物半導体ウエハや、Al2O3(サファイア)ウエハが不可欠です。
これらは優れた電気的・熱的特性を持ちますが、わずかな金属不純物によって、デバイスの性能劣化、歩留まり低下、信頼性の低下や品質の悪化を招く恐れがあります。そのため、ウエハ表面の汚染を高精度に分析・評価し、厳密に管理することが重要です。
ここでは、化合物半導体ウエハおよびサファイアウエハの表面分析事例をご紹介します。
分析結果
GaNウエハ
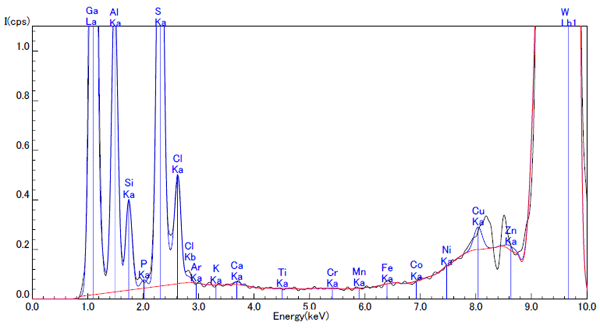
GaNウエハの分析では、ウエハ由来のGaが強く検出されるため、一部元素の存在を正確に判断することが困難になります。
特にCu、Znの検出に顕著な影響を与えます。
AlGaNウエハ
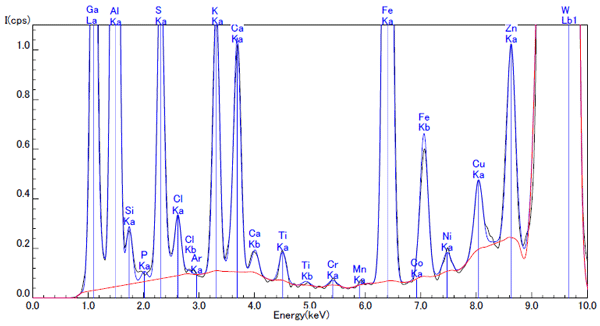
AlGaNウエハの分析では、ウエハ由来のAl、Gaが強く検出されるため、一部元素の存在を正確に判断することが困難になります。
特にCu、Znの検出に顕著な影響を与えるほか、Alの検出によってSiの検出にも軽微な影響を与えます。
GaAsウエハ
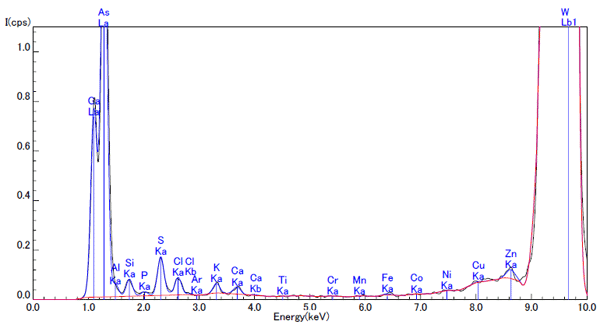
GaAsウエハの分析では、ウエハ由来のGa、Asが強く検出されるため、一部元素の存在を正確に判断することが困難になります。
特にCu、Znの検出に顕著な影響を与えるほか、Asの検出によってAlの検出にも影響を与えます。
SiCウエハ

SiCウエハの分析では、ウエハ由来のSiが強く検出されるため、一部元素の存在を正確に判断することが困難になります。
特にAlの検出に顕著な影響を与えるほか、SiのサムピークやWのエスケープピークが検出された場合、K、Ca、Cuの検出にも影響を与えます。
また、Siウエハに比べ、試料表面のラフネス等によりバックグラウンドが上昇する可能性があります。
Al2O3ウエハ

Al2O3ウエハの分析では、ウエハ由来のAlが強く検出されるため、一部元素の存在を正確に判断することが困難になります。
特にSiの検出に軽微な影響を与えます。
InPウエハ
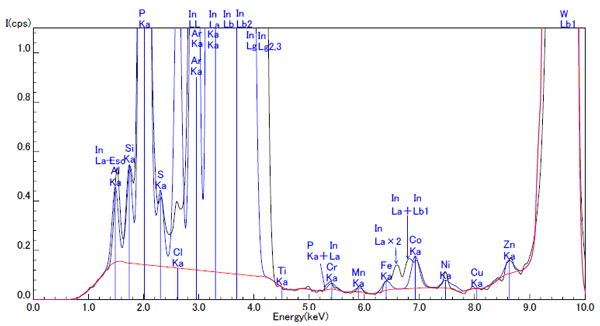
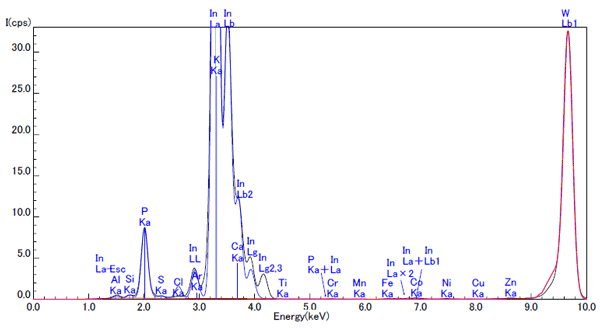
InPウエハの分析では、ウエハ由来のPとInが強く検出されるため、一部元素の存在を正確に判断することが困難になります。
特にInは多くの副線(Lβ、Lγなど)やサムピーク・エスケープピークが検出され、Al、Ar、K、Ca、Cr、Fe、Coなどの検出に顕著な影響を与えます。
お問い合わせ
ウエハ汚染評価について、お困りごとはありませんか?
ご相談・お見積りなど、ぜひお気軽にお問い合わせください。